Asia-Pacific Region Intelligence Center
삼성전자 “HBM 16단부터 하이브리드 본딩 필수” 본문
삼성전자 “HBM 16단부터 하이브리드 본딩 필수”
CIA bear 허관(許灌) 2024. 6. 8. 15:16
삼성전자가 16단 이상 고대역폭메모리(HBM) 양산에 하이브리드 본딩 기술이 꼭 필요하다는 입장을 견지했다. 16단까지 어드밴스드 매스리플로우-몰디드언더필(MR-MUF)를 적용하겠다는 SK하이닉스와 상반되는 로드맵이다.
7일 업계에 따르면 삼성전자는 지난달 말 미국 콜로라도주 덴버에서 개최된 제74회 전자부품기술학회(ECTC)에서 ‘HBM 적층을 위한 D2W 하이브리드 구리(Cu) 본딩 기술 연구’ 논문을 발표했다.
삼성전자는 논문에서 “16단 이상 HBM에는 하이브리드 본딩 기술이 필수적”이라고 강조했다.
하이브리드 본딩은 차세대 패키지 기술 중 하나다. 실리콘관통전극(TSV)이 형성된 칩을 수직으로 쎃을 때 범프 없이 다이렉트로 붙이는 컨셉이다. 업계에선 다이렉트 본딩이라고 부르기도 한다. 열압착(TC) 본딩 대비 적층 칩 높이와 열 방출 개선이 가능하다는 장점이 있다.
삼성전자는 HBM4 16단 양산에 하이브리드 본딩 적용이 필요한 이유로 패키지 높이를 꼽았다. 제한된 폼팩터(775μm) 안에 17개(베이스 다이 1개+코어 다이 16개) 칩을 적층하기 위해서는 하이브리드 본딩을 통해 칩 간 갭을 최대한 줄여야한다는 것이다. 삼성전자는 12단 HBM 제품까지 TC-비전도성접착필름(NCF) 방식을 적용해 칩을 적층하고 있다.
제한된 폼팩터 안에 칩을 적층하기 위한 방법은 크게 세 가지가 있다. 코어 다이를 최대한 얇게 만드는 방법과 범프 피치를 줄이는 방법, 하이브리드 본딩을 적용 등이다.
업계에서는 코어 다이를 얇게 만드는 것과 범프 피치를 줄이는 것이 한계에 다다른 것으로 보고 있다. 업계 관계자는 “코어 다이를 30μm 아래로 가공하는 것은 쉽지 않다”고 귀띔했다. 삼성전자는 논문에서 “범프를 통한 칩 간 연결은 (범프) 부피 때문에 높이를 줄이는 데 한계가 있다”며 “또, 마이크로 범프를 통한 연결은 범프 쇼트 이슈로 (범프 간) 피치를 줄이기 어렵다”고 설명했다.
삼성전자는 이 논문에서 하이브리드 본딩을 통한 HBM 제조 방법을 공개하기도 했다. 로직 웨이퍼의 경우, 화학적기계연마(CMP)와 플라즈마 조사 공정을 거친다. 이후, DI 워터 린스 공정 후 칩을 적층한다. 코어 다이는 CMP 후, 다이 싱귤레이션 공정을 진행한다. 이후 과정은 로직 웨이퍼와 동일하다. 플라즈마 조사와 DI 워터 린스를 진행하는 이유는 표면 활성화 때문이다. 이 과정을 거쳐야만 -OH기가 만들어지고, 이를 통한 분자 간 결합이 이뤄진다. 마지막으로 어닐링 과정을 거치면 Cu도 결합된다.

삼성전자는 지난 4월 세메스 하이브리드 본딩 장비를 통해 16단 HBM3 샘플을 만들었고, 정상 작동했다고 밝히기도 했다. 하이브리드 본딩 장비는 세메스 외에도 베시(BESI), 한화정밀기계 등이 개발하고 있다.
삼성전자는 16단 제품이 주력이 될 HBM4 제품 샘플을 2025년 개발한 뒤 2026년부터 본격 양산할 계획이다.
- 하이브리드 본딩은 차세대 패키지 기술 중 하나다. 실리콘관통전극(TSV)이 형성된 칩을 수직으로 쎃을 때 범프 없이 다이렉트로 붙이는 컨셉이다. 업계에선 다이렉트 본딩이라고 부르기도 한다. 열압착(TC) 본딩 대비 적층 칩 높이와 열 방출 개선이 가능하다는 장점이 있다
[인터뷰] AI 시대 삼성전자 HBM이 만들어 내는 완벽한 하모니
고대역폭 메모리 'HBM(High Bandwidth Memory)'은 초거대 AI 시대라는 악곡(樂曲)의 뛰어난 오케스트라 연주자로 비유할 수 있다. 마치 능숙한 연주자가 빠르고 정확하게 멜로디를 연주하는 것처럼, HBM은 높은 대역폭을 기반으로 AI의 방대한 데이터를 효율적으로 처리한다.
삼성전자는 2024년 2월, 업계 최초로 36GB HBM3E(5세대 HBM) 12H D램 개발에 성공했다. 36GB HBM3E 12H D램은 24Gb D램 칩을 TSV(Through-silicon Via, 실리콘 관통 전극) 기술로 12단까지 적층한 메모리다. 해당 제품은 지난달 엔비디아의 연례 개발자 콘퍼런스 'GTC(GPU Technology Conference) 2024'에서 공개되어 고객들로부터 뜨거운 반응을 받기도 했다.
이에 뉴스룸은 삼성전자 HBM을 담당하는 상품기획실 김경륜 상무와 DRAM개발실 윤재윤 상무를 만나 보았다. 두 담당자의 인터뷰를 통해 기술 혁신을 이끄는 삼성전자의 HBM을 들여다보자.




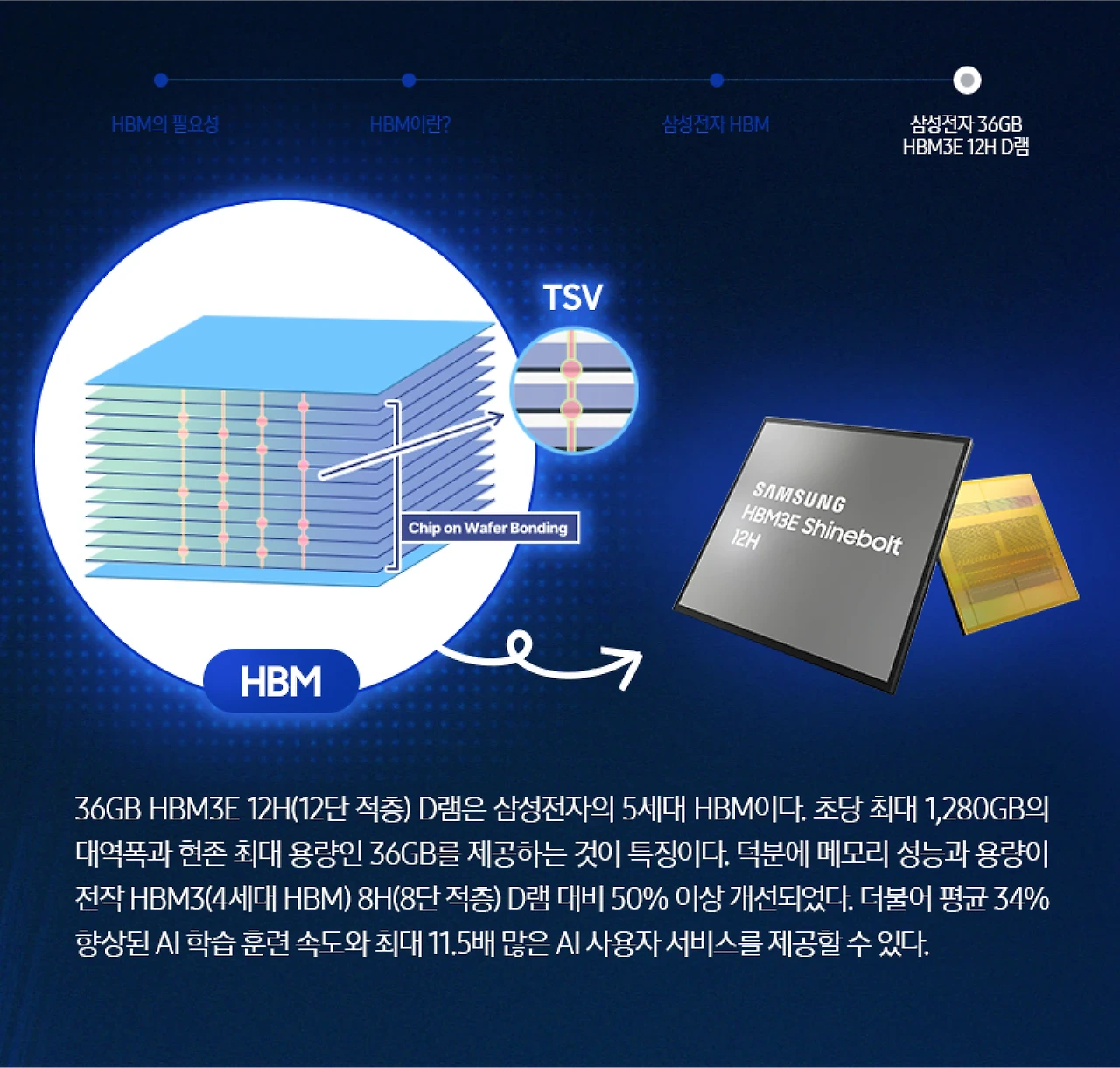







삼성전자는 2016년 업계 최초로 AI 메모리 시장의 막을 연 이래 독보적인 기술 노하우를 바탕으로 AI 반도체 생태계를 확장해 왔다. 초격차 기술력으로 무한한 가능성을 열어 온 삼성전자가 그려 갈 앞으로의 미래가 기대된다.
[인터뷰] AI 시대 삼성전자 HBM이 만들어 내는 완벽한 하모니 | 삼성반도체 (samsung.com)
[인터뷰] AI 시대 삼성전자 HBM이 만들어 내는 완벽한 하모니 | 삼성반도체
삼성전자는 2024년 2월, 업계 최초로 36GB HBM3E(5세대 HBM) 12H D램 개발에 성공했다.
semiconductor.samsung.com
'Guide Ear&Bird's Eye6 > 산업의 쌀 반도체(5G. 인공지능, 자율주행. 태양광 재생에너지 등 )' 카테고리의 다른 글
| 삼성, 파운드리·메모리·패키징 원스톱 제공 'AI 턴키' 꺼냈다 (0) | 2024.06.17 |
|---|---|
| 삼성전자, 파운드리 포럼 2024 개최 AI 시대 파운드리 비전 제시 (0) | 2024.06.15 |
| 젠슨 황 엔비디아 CEO가 '기술계의 테일러 스위프트'로 불리는 이유는? (0) | 2024.06.08 |
| 삼성·SK하이닉스·마이크론, HBM4 패권 경쟁 본격화 (0) | 2024.06.07 |
| 젠슨황 엔비디아 CEO "삼성전자로부터 HBM 공급받을 것" (0) | 2024.06.06 |





